如何通过IGBT模块内置的NTC电阻测量芯片结温?
- 文件版本 :
摘要
IGBT模块的芯片温度是电力电子系统非常重要的参数。由于无法直接测量系统运行时的芯片温度,所以得要借助其它的温度传感器,比如IGBT模块内置的NTC电阻,根据NTC电阻的实时数值,通过查询预先测量的芯片温度-NTC电阻温度关系曲线,间接预估芯片温度。所以提前确定芯片温度和温度传感器的关系曲线是非常重要的工作。本文基于特定的实验装置,介绍了一种简易可靠的测量方法,以获取芯片温度和NTC电阻的对应关系。
介绍
在设计电力电子系统的初始阶段,通常会做电气仿真和热仿真。对于热仿真来说,尽可能准确的确定IGBT芯片温度对于预测模块寿命至关重要。虽然JEDEC标准[1]定义了in-site结温测量方法,但是此方法的设备使用困难并且很难在实际运行的系统中进行测量。另外一种估计芯片温度的简易方法如图1左侧的实验平台所示。

被测器件是英飞凌公司的一款PrimePACK模块FF1000R17IE4(1000A/1700V),固定在风冷散热器上并且冷却风速可调。通过测量保证散热器风量和实际系统的工况相同。芯片的温度用红外热成像仪测量(IR-Camera),芯片下方的基板壳温用贴在基板上的热电偶测量。NTC电阻值通过数据采集器记录并且根据IGBT模块数据手册中的电阻-温度曲线将电阻值转换成对应的温度值,同时用红外热成像仪直接测量NTC电阻的温度。被测器件通过低压直流源供电,当大电流通过芯片时,在芯片上产生压降和损耗,从而为芯片加热。图1中的右图是被测器件的热成像图,通过调节直流源的输出电流,可以改变芯片的加热功率,进而得到不同发热功率下的芯片温度。待芯片温度稳定后,记录数据采集器和热成像仪的测量结果,如表1所示:

借助数据处理工具,比如Excel,对测量的NTC电阻[Ω]和二极管温度[℃]进行校正,便可得到两者的对应关系tdiode=f(RNTC),见图2,其中还包括相应的多项式插值公式。
图2中的非线性曲线需要用3次多项式插值才能准确描述。NTC电阻的特性参数通常由半导体的规格书给出,所以可以很容易的把NTC电阻值转换成对应的温度值。用NTC电阻的温度替换图2中的NTC电阻值,便可得到NTC电阻温度和芯片温度的线性对应关系tdiode=f(TNTC),如图3所示。

系统的冷却方式对散热的影响也比较大。在风冷系统中,模块产生的热量在基板和散热器上横向传播,能充分的加热NTC电阻。如果采用高效的水冷系统,热量在基板水平方向的扩散程度较低,从而减弱了与NTC电阻的热耦合。所以,在水冷系统中,芯片和NTC电阻之间的温差会增加。与风冷系统相同的热测试(相同的模块,相同的热负载)也在水冷系统上进行了重复试验,如图4所示。

表2是水冷系统的热测试结果,包括低流速(5.6L/min)和高流速(12.8L/min)两种水冷工况。在每种工况下,通过调节芯片的电流,使芯片的稳态温度尽量一致。

为了便于对比,图5列出了上述风冷和水冷系统的NTC电阻温度和芯片温度之间的关系曲线。
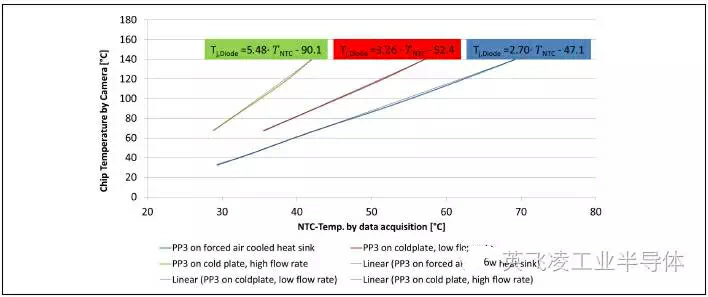
热测试结果表明,芯片和NTC电阻之间的温度差随冷却系统性能的提升而增加,所以对于不同的系统应用工况,无法给出通用的芯片-NTC电阻温度曲线。
模型的局限
本文的热测试方法简要介绍了获取模块内部芯片温度与NTC电阻(电阻值、温度值)之间的关系曲线。如果想获得更加精确的关系曲线,则需要仔细考虑测试过程中每一步的细节,尤其是当确定过载保护的触发值时,必须更加准确的测量温度。
1)本方法的有效性
本文的所有测试数据均是在被测系统热稳定后测量的,忽略了系统热时间常数(热容)的影响,所以测量结果仅在稳态工况下有效。强迫风冷系统的热时间常数大约为几分钟,水冷系统的热时间常数大约为30到60秒,NTC电阻需要较长的时间才能响应系统负载工况变化,所以用它来监控系统的瞬态工况是不可能的。导致系统过载的工况较多,比如水冷散热器被腐蚀引起的冷却系统性能降低、冷却风扇故障或者冷却水泵损坏等。以上故障通常是逐渐加剧的,NTC电阻有足够的响应时间,所以可以用来做系统的过载保护。建议在系统实际工况下测试芯片和NTC电阻的关系曲线,通过设置合适的触发值,就可以用NTC电阻来过载保护。
2)最热点vs Tvj,max
在测量系统热模型时,需要用芯片的最大温度点作为参考。当用热成像设备比如红外热成像仪测量芯片温度时,测得的最热点与芯片表面的最高温度Tvj,max不同。标准中的in-situ测温方法考虑了模块内部的所有芯片,得到的是芯片最大平均温度,这个值可以用来预测模块的PC寿命[4]。本试验中的红外热成像仪能探测芯片表面的最热点,但是根据这个最热点得到的热模型相当保守。尤其是对于大功率模块,用in-situ方法测得的温度是所有芯片温度的平均值。为了使红外测温的热模型接近in-situ方法测温的热模型,需要考虑模块的所有发热芯片并仔细分析热测试数据,对所测数据取平均值。如图6所示,热成像数据得到的最高温度在绑定线上,为104℃。芯片表面的最高温度比绑定线稍微低一点,大约为100℃,而芯片表面的平均温度只有93℃。
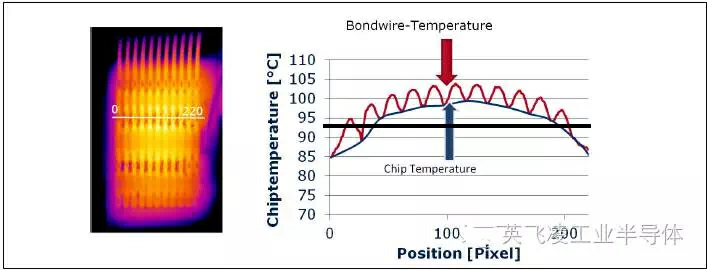
3)直流源vs交流源
在实际系统中,模块中的IGBT芯片和二极管芯片同时发热,芯片之间有热耦合。为了便于操作,本实验采用直流源加热被测模块的二极管芯片,忽略了芯片之间的热耦合。为了使芯片发热和彼此之间的耦合更接近实际工况,可以采用交流源代替直流源。参考文献[5]详细介绍了交流源加热芯片的方法。
结论
对于内置NTC电阻的功率模块来说,芯片和NTC电阻之间没有通用的关联模型(热阻或者温度关系)。在特定的系统中进行热测试,是精确获得两者相互关系的必然手段。本实验基于特定的实验平台,通过对稳态热测试数据进行拟合,得到了NTC电阻和芯片温度之间的关系曲线。红外热成像方法的测温数据非常全面,包括芯片的热梯度和最热点等信息,同时还可以借助这种测温方法总体考虑整个系统的热设计。
.png)